一、芯片简介
芯片其实就是一堆晶体管集成在一个小片子上。不同的芯片里晶体管的数量差别很大,有的可能有几十亿个,有的只有几十、几百个。每个晶体管有两种状态:开和关,用1和0来表示。
芯片的制造过程涵盖了芯片设计、芯片加工以及芯片封测三大环节。基于这一制造流程,芯片厂商被划分为四种类型:Fabless(专注于半导体设计的公司)、Foundry(晶圆代工厂)、IDM(集成设备制造商,即垂直一体化模式)和OSAT(封测厂)。我们日常在电路板上所见的,往往是经过OSAT厂封装后的产品。这种封装后的电路板更便于进行焊接与测试。而对于高频电路,通常不再采用封装芯片,而是直接使用管芯,通过金丝键合进行连接,并进行密封处理。接下来我们来了解下芯片封装。
二、芯片封装的意义是什么?
芯片封装是将集成电路(芯片)包裹在保护性外壳中的过程。芯片封装的意义主要体现在以下几个方面:
保护芯片:封装可以保护芯片免受物理损伤和电磁干扰。芯片本身非常脆弱,容易受到机械振动、静电放电等因素的影响,导致损坏或性能下降。封装能够有效地保护芯片,降低其受损风险,同时隔离外部腐蚀和水汽,避免内部发生化学腐蚀和氧化。
连接功能:封装实现芯片与外部电路的连接,构成完整的电子系统。现代电子系统对芯片的要求越来越高,需要实现更多复杂的功能,封装技术能够确保芯片与外部电路的精密连接,提升系统的性能和功能。如下图所示,芯片内部的连接金属丝在1-1.5μm左右,十分脆弱,其无法与电路板焊接连接。而通过封装后留在外部的引脚排布整齐,且选用了易于焊接的材料,焊接后强度也足够。
散热功能:封装设计还包括散热功能,确保芯片在运行时不会因过热而影响性能和寿命。通过封装中的散热设计,可以有效散发芯片产生的热量,保证其正常运行。
可靠性:其实和防护有点关系,但主要是考虑一些机械压力,温度,湿度,化学腐蚀等损害,封装材料等选择会直接影响到芯片的期的可靠性,因此芯片的工作寿命,主要决于对封装材料和封装工艺的选择。
三、芯片封装有哪些分类?
BGA封装(Ball Grid Array):BGA封装是一种在芯片底部使用焊球连接的封装形式。BGA封装的特点是引脚密度高、连接可靠性强,因此在高性能和大规模集成的芯片上得到广泛应用。
QFN封装(Quad Flat No-leads Package):QFN封装是一种没有外露引脚的封装形式,引脚位于封装底部。QFN封装具有体积小、散热性能好和安装简便等优点,常用于尺寸有限的应用场景。
QFP封装(Quad Flat Package):QFP封装是一种具有四个平面引脚的封装形式。它适用于需求较高的应用,如处理器和图形芯片。
TSSOP(Thin Shrink Small Outline Package)是一种薄型封装形式。与传统的SOP封装相比,TSSOP封装具有更小的体积和更窄的引脚间距,使其在高密度集成电路应用中得到广泛应用。
DIP封装(Dual Inline Package):DIP封装是最早使用的一种芯片封装形式,具有两排引脚并呈直线排列。
PLCC(Plastic Leaded Chip Carrier)封装是一种常见的方形芯片封装形式。引脚位于封装的四周。它通常用于集成电路密度较低的应用。
SOP封装(Small Outline Package):SOP封装是一种小型封装形式,具有两排细小的铅脚。SOP封装在电子消费品中广泛使用。
PGA封装(Pin Grid Array):PGA封装是一种引脚网阵列封装形式,引脚以网格状排列在封装底部,通常通过插入式封装方式安装到插座或者插针上。PGA封装具有较高的引脚密度,适用于需要较多引脚连接。
TSOP封装(Thin Small Outline Package):TSOP封装是一种薄型封装适用于高速存储器和微控制器等应用。
TQFP封装(Thin Quad Flat Package):TQFP封装是一种常见的表面贴装封装形式,具有四个直边并且相对薄型的外形。
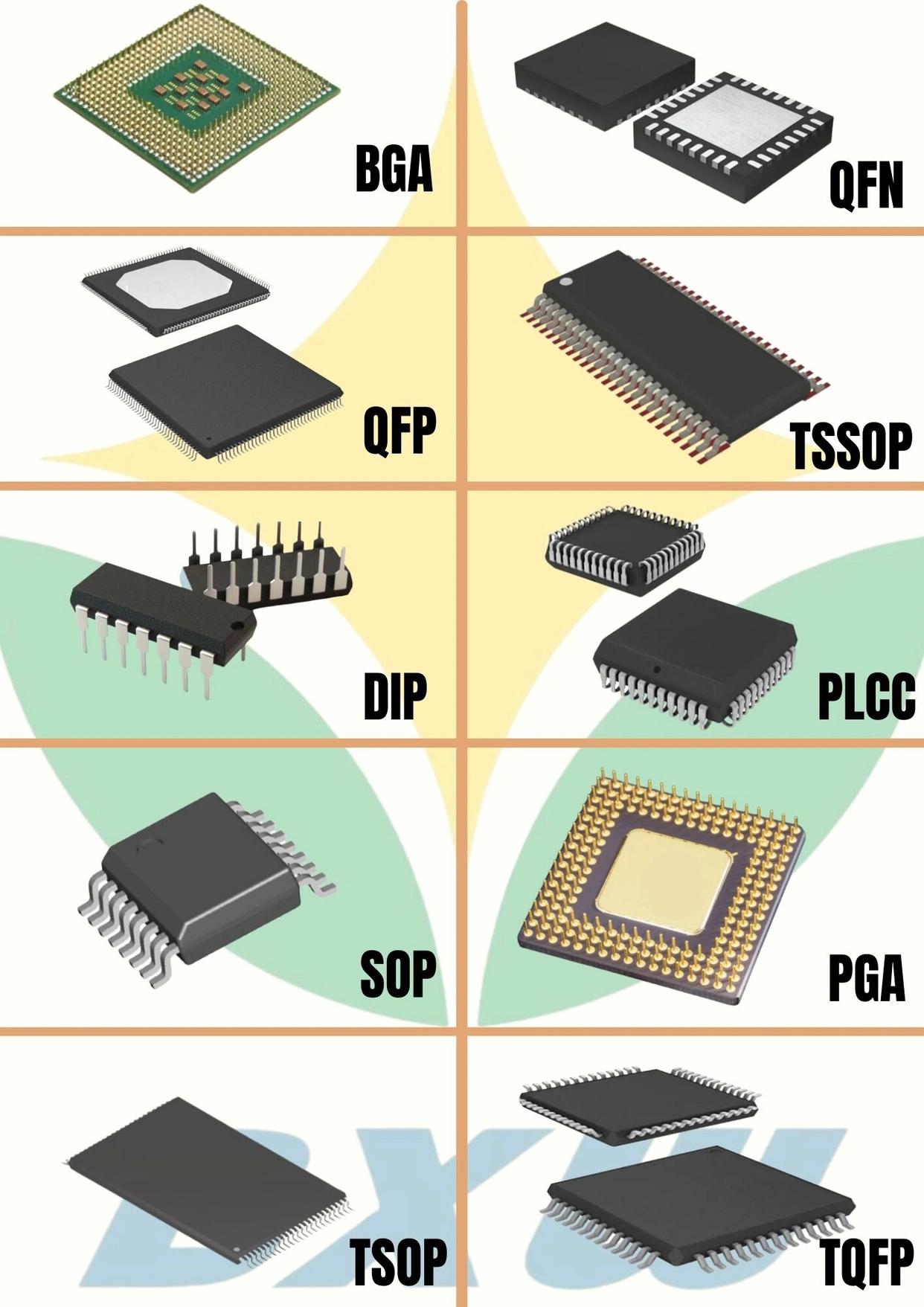
四、芯片封装技术的进化史
芯片封装技术的发展,从20世纪70年代至今,经历了几个重要的阶段,推动了电子产品的小型化、轻量化和高性能化。以下是这一技术的主要发展阶段:
第一阶段:20世纪70年代以前(通孔插装时代),DIP(双列直插式)封装是主流,通过插脚直接安装在PCB板上。这种方式虽然简单,但密度和频率较低,难以满足自动化生产的需求。
第二阶段:20世纪80年代以后(表面贴装时代),SOP(小外形封装)和QFP(四边扁平封装)开始流行,引线替代了插脚,使得封装密度提高,体积减小。
第三阶段:20世纪90年代以后(面积阵列封装时代),BGA(球栅阵列封装)、CSP(芯片尺寸封装)和WLP(晶圆级封装)等先进技术出现,引线被取消,进一步缩小了体积并提升了系统性能。
第四阶段:20世纪末以后,多芯片组件、三维封装和系统级封装开始崭露头角。
第五阶段:21世纪以来,系统级单芯片封装(SoC)和微机电机械系统封装(MEMS)成为主流。目前,全球半导体封装的主流正处于第三阶段的成熟期和快速发展期,CSP、BGA、WLP等封装形式已进入大规模生产阶段,并逐渐向第四、第五阶段过渡。
从历史发展来看,半导体封装技术的趋势可以总结为:从有线连接到无线连接,从芯片级封装到晶圆级封装,从二维封装到三维封装。
五、芯片制造设备配件常用的PFA产品有哪些?
1、PFA管,PFA管常见规格:
1/8英寸(1.6*3.2mm)、1/4英寸(3.96*6.35mm)、3/8英寸(6.35*9.525mm)、
1/2英寸(9.5*12.7mm)、3/4英寸(15.88*19.05mm)、1英寸(22.2*25.4mm)。
2、PFA接头,PFA焊接接头,PFA入珠接头,PFA扩口接头,三氟莱常见规格:包括1/8英寸、1/4英寸、3/8英寸、1/2英寸、3/4英寸和1英寸。
3、PFA阀门,常见规格:通常为1寸以下英制尺寸,如1/4寸、3/8寸、1/2寸、3/4寸、1寸。
4、PFA注塑件
三氟莱,高纯氟塑料制品生产厂家,半导体工厂高纯PFA管供应商。
本文由三氟莱PFA管小姐姐原创,欢迎关注,带你一起长知识!